иӢҸе·һзәізұіжүҖеңЁGaNеҹәеҠҹзҺҮеҷЁд»¶з•ҢйқўжҺ§еҲ¶з ”究дёӯеҸ–еҫ—иҝӣеұ•
ж°®еҢ–й•“пјҲGaNпјүеҹәй«ҳз”өеӯҗиҝҒ移зҺҮжҷ¶дҪ“з®ЎпјҲHEMTпјүе…·жңүй«ҳз”өжөҒеҜҶеәҰгҖҒй«ҳејҖе…ійҖҹеәҰе’ҢдҪҺеҜјйҖҡз”өйҳ»зӯүдјҳзӮ№пјҢеҸ—еҲ°дәә们зҡ„е№ҝжіӣе…іжіЁпјҢдҪҝеҫ—GaNеҹәHEMTеҷЁд»¶жҲҗдёәдёӢдёҖд»ЈеҠҹзҺҮеҷЁд»¶ејәжңүеҠӣзҡ„з«һдәүиҖ…гҖӮ然иҖҢпјҢGaNеҷЁд»¶дёҺдј з»ҹSiеҹәеҷЁд»¶дёҚеҗҢпјҢеҫҲйҡҫйҖҡиҝҮзғӯж°§еҢ–зҡ„ж–№жі•иҺ·еҫ—дҪҺз•ҢйқўжҖҒеҜҶеәҰзҡ„з»қзјҳд»ӢиҙЁеұӮгҖӮеӣ жӯӨпјҢеҰӮдҪ•йҷҚдҪҺз•ҢйқўжҖҒеҜҶеәҰе·Із»ҸжҲҗдёәGaNеҹәеҷЁд»¶з ”究е’Ңеә”з”Ёзҡ„жҢ‘жҲҳд№ӢдёҖгҖӮ
дёӯеӣҪ科еӯҰйҷўиӢҸе·һзәізұіжҠҖжңҜдёҺзәізұід»ҝз”ҹз ”з©¶жүҖзәізұіеҠ е·Ҙе№іеҸ°з ”究е‘ҳеј е®қйЎәиҜҫйўҳз»„дёҖзӣҙиҮҙеҠӣдәҺй«ҳеҺӢеӨ§еҠҹзҺҮGaNеҹәз”өеҠӣз”өеӯҗеҷЁд»¶зҡ„з ”з©¶е·ҘдҪңгҖӮзӣ®еүҚпјҢйҖҡиҝҮиҮӘдё»з ”еҸ‘д»ҘеҸҠдёҺйҰҷжёҜ科жҠҖеӨ§еӯҰж•ҷжҺҲйҷҲ敬иҜҫйўҳз»„иҝӣиЎҢеҗҲдҪңпјҢеҲ©з”ЁLPCVDпјҲдҪҺеҺӢеҢ–еӯҰж°”зӣёжІүз§ҜпјүжІүз§Ҝж …д»ӢиҙЁеұӮе’ҢиЎЁйқўй’қеҢ–еұӮжҠҖжңҜпјҢе·Із»Ҹе®һзҺ°дәҶдҪҺжјҸз”өгҖҒй«ҳиҖҗеҺӢзҡ„GaN еҹәHEMTеҠҹзҺҮеҷЁд»¶пјҢзӣёе…із»“жһңеҸ‘иЎЁеңЁIEEE Transactions on Electron Devicesе’ҢеӣҪйҷ…дјҡи®®IEDMдёҠгҖӮ
дёәдәҶиҝӣдёҖжӯҘйҷҚдҪҺLPCVD-Si3N4дёҺGaNзҡ„з•ҢйқўжҖҒеҜҶеәҰпјҢжҸҗй«ҳеҷЁд»¶зҡ„жҖ§иғҪгҖӮеј е®қйЎәиҜҫйўҳз»„йҖҡиҝҮеҜ№дј з»ҹLPCVDзі»з»ҹиҝӣиЎҢж”№йҖ пјҢеңЁеӣҪйҷ…дёҠйҰ–ж¬ЎжҸҗеҮәе°ҶеҺҹдҪҚзӯүзҰ»еӯҗдҪ“еӨ„зҗҶдёҺдј з»ҹLPCVDжІүз§Ҝзӣёз»“еҗҲжқҘжІүз§Ҝд»ӢиҙЁеұӮпјҢе®һзҺ°еңЁжІүз§ҜSi3N4и–„иҶңеүҚзҡ„еҺҹдҪҚN2зӯүзҰ»еӯҗдҪ“ж°®еҢ–еӨ„зҗҶ(еӣҫ1)пјҢN2зӯүзҰ»еӯҗдҪ“еӨ„зҗҶдёҚд»…еҸҜд»ҘиЎҘеҒҝGaNиЎЁйқўзҡ„ж°®з©әдҪҚпјҢиҝҳеҸҜд»ҘеҮҸе°‘иЎЁйқўзҡ„иҮӘ然氧еҢ–еұӮпјҢд»ҺиҖҢиҺ·еҫ—иҫғдҪҺзҡ„LPCVD-Si3N4/(Al)GaNз•ҢйқўжҖҒеҜҶеәҰпјҢйҖҡиҝҮиҝҷз§ҚжҠҖжңҜеҲ¶дҪңзҡ„MIS-HEMTsеҷЁд»¶пјҢеңЁжү«жҸҸж …еҺӢдёәVG-sweep =24 Vж—¶пјҢйҳҲеҖјеӣһж»һз”ұеҺҹжқҘзҡ„7.1 VдёӢйҷҚеҲ°186 mVпјҢеҷЁд»¶зҡ„йҳҲеҖјзЁіе®ҡжҖ§еҫ—еҲ°жҳҺжҳҫжҸҗй«ҳпјҢеҰӮеӣҫ2жүҖзӨәгҖӮз”ұдәҺз•ҢйқўжҖҒзҡ„йҷҚдҪҺжҠ‘еҲ¶дәҶйҷ·жҖҒеҜ№жІҹйҒ“дёӯз”өеӯҗзҡ„жҚ•иҺ·пјҢеӣ иҖҢж”№е–„дәҶеҷЁд»¶зҡ„еҠЁжҖҒзү№жҖ§пјҢеңЁ600 Vе…іжҖҒеә”еҠӣдёӢпјҢеҷЁд»¶зҡ„еҜјйҖҡз”өйҳ»д»…д»…дёҠеҚҮ1.18еҖҚпјҲдј з»ҹеҷЁд»¶дёә200еҖҚе·ҰеҸіпјүпјҢеҰӮеӣҫ3жүҖзӨәгҖӮеҷЁд»¶з»јеҗҲжҖ§иғҪеӨ„дәҺеӣҪйҷ…еүҚеҲ—пјҢзӣёе…із»“жһңеҸ‘иЎЁеңЁжңҖж–°зҡ„IEEE Electron Device Letters, 2017,38,236гҖӮ
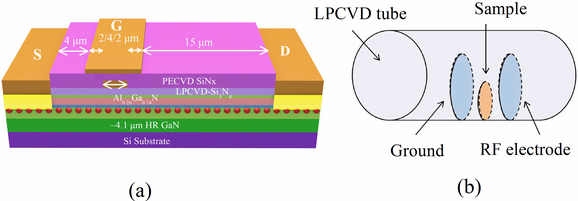
еӣҫ1гҖҒ(a) еҺҹдҪҚж°®зӯүзҰ»еӯҗеӨ„зҗҶAlGaN/GaN MIS-HEMTs з»“жһ„еү–йқўеӣҫпјӣ(b) ж”№йҖ еҗҺзҡ„LPCVDпјҲдҪҺеҺӢж°”зӣёжІүз§Ҝпјүзі»з»ҹзӨәж„Ҹеӣҫ
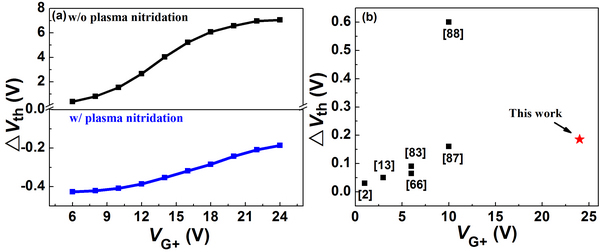
еӣҫ2гҖҒпјҲaпјүз»ҸиҝҮе’ҢжңӘз»ҸиҝҮеҺҹдҪҚN2зӯүзҰ»еӯҗдҪ“еӨ„зҗҶзҡ„MIS-HEMTеҷЁд»¶еңЁдёҚеҗҢжӯЈеҗ‘жү«жҸҸж …еҺӢдёӢзҡ„йҳҲеҖјеӣһж»һпјӣпјҲbпјүеҷЁд»¶жӯЈеҗ‘жү«жҸҸж …еҺӢе’ҢйҳҲеҖјеӣһж»һдёҺе·ІжҠҘйҒ“ж–ҮзҢ®з»“жһңзҡ„жҜ”иҫғ
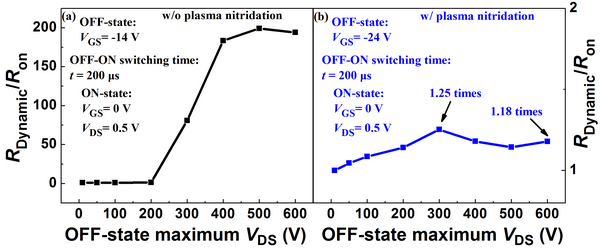
еӣҫ3гҖҒпјҲaпјүжңӘз»ҸиҝҮеҺҹдҪҚзӯүзҰ»еӯҗдҪ“еӨ„зҗҶMIS-HEMTеҷЁд»¶зҡ„еҠЁжҖҒзү№жҖ§пјӣпјҲbпјүз»ҸиҝҮеҺҹдҪҚзӯүзҰ»еӯҗдҪ“еӨ„зҗҶMIS-HEMTеҷЁд»¶зҡ„еҠЁжҖҒзү№жҖ§

 зІӨе…¬зҪ‘е®үеӨҮ 44030902003195еҸ·
зІӨе…¬зҪ‘е®үеӨҮ 44030902003195еҸ·