作者:刘立,胡磊,丑修建
摘 要: 从驱动方式和机械结构的角度介绍了不同的RF MEMS开关类型,分析了各类MEMS开关的性能及优缺点,分析了MEMS开关在制作和发展中面临的牺牲层技术、封装技术、可靠性问题等关键技术和问题,介绍了MEMS开关的发展现状及其在组件级和系统级的应用,以及对MEMS开关技术的展望。
0 引言
RF MEMS是MEMS(微机电系统)与RF(射频)技术相结合的一门新技术, MEMS器件具有体积小、易集成、功耗低、可靠性高等优点,可代替传统无线通信系统中的半导体器件。RF MEMS不仅可以以器件的方式应用于电路,例如MEMS开关、MEMS电容、MEMS谐振器;还可以将单个器件集成到同一芯片组成组件和应用系统,例如滤波器、压控振荡器、移相器、相控阵雷达天线等,这大大缩减了传统器件的体积,降低了功耗,提升了系统的性能。RF MEMS开关作为RF MEMS中的重要器件之一,其性能对微机电系统的影响日益深远。
1 MEMS开关的分类及现状
根据MEMS开关机械结构的驱动方式可将开关分为静电驱动、电磁驱动、电热驱动和压电驱动:
(1)静电驱动式开关主要依靠开关上下极板之间的静电力来控制开关的闭合。优点:制作简单、易集成;缺点:驱动电压高、易受环境影响、稳定性差。
(2)电磁驱动式开关利用电流产生的磁场力驱动可动构件来实现开关通断。优点:驱动电压低、驱动力高、不易受环境影响、不易被击穿;缺点:稳定性差、不易控制。
(3)电热驱动式开关利用材料通电产生的热膨胀效应来实现开关动作。热驱动的优点是制作简单、驱动电压低、接触力大、开关动作幅度大;缺点是开关时间长、功耗高。
(4)压电驱动的开关是利用压电材料通电产生的逆压电效应实现开关的通断。优点:稳定性较强、驱动电压低、功耗低;缺点:技术尚未成熟、工艺复杂。
静电驱动方式技术较为成熟,研究最为广泛,是目前应用最多的驱动机制。根据开关接触方式可分为电容耦合式和欧姆接触式,根据开关接入射频电路的方式可分为串联式和并联式。将上述两类开关组合就形成了串联电容式、并联电容式、串联接触式、并联接触式开关。
1.1 电容式开关
电容式MEMS开关的工艺相对简单,主要组成部分为可动结构、金属电极、信号传输线、绝缘介质层。通过机械运动调节可动结构与传输线之间的空气间隙来控制开关的通断,该类开关主要应用于高频段,是目前研究较为广泛的MEMS开关。

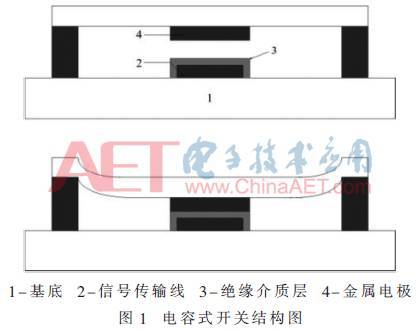
(1)串联电容式开关
串联电容式MEMS开关将电容耦合至传输线的输出端。未加电压时,输入输出端的电容很小,信号无法通过耦合电容,开关呈“开”态;当加入电压时,可动结构受到静电力向输出端移动,输入输出之间的电容变大,信号被耦合至输出端,开关呈“关”态。
串联电容式开关的研究较少,侯智昊[1]等利用薄膜沉积中产生的内应力使MEMS桥膜向上发生翘曲,提高了开关的隔离度,其插入损耗为-0.88 dB@3 GHz,在-0.5 dB@6 GHz,隔离度为-33.5 dB@900 MHz、-24 dB@3 GHz和-20 dB@5 GHz,适合应用于3~5 GHz频段。
(2)并联电容式开关
并联电容式开关是将电容耦合至地线,工作原理同串联电容式开关相同,而结构略有不同。当不加电压时,开关处于“开”态,当加上驱动电压时,金属膜与绝缘材料形成的电容最大,高频信号被耦合至地线,开关实现“关”态。
Reytheon公司[2]研制的并联开关已达世界顶尖水平,其主要参数为驱动电压30 V,插入损耗<0.2 dB@30 GHz,隔离度>40 dB@30 GHz。
1.2 接触式开关
接触式MEMS开关是利用金属—金属直接接触来形成信号通路,在微波传输的较高频段,金属接触易产生寄生效应,故该类开关常应用于低频段。开关的上下极板在外加电压的驱动下产生静电力,使开关闭合并将信号传输线导通;当撤除外加电压,开关的上电极板通过自身的机械回复力使开关断开。接触式MEMS开关一般分为串联式和并联式,两种开关导通原理相同,区别在于信号传输线的导通方式不同。

(1)串联接触式开关
以悬臂式结构的开关为例,当开关电压加到驱动电压以上时,开关上下接触电极间的静电力将悬臂梁拉下,信号在地线与信号线之间形成微波通路,接触电极以串联的形式将信号线导通。
Yao[3]采用表面微加工工艺制作了一种单刀单掷接触串联式MEMS开关,该开关具有很好的工艺兼容性,驱动电压30 V,开关寿命也相对延长。隔离度>50 dB@<40 GHz,插入损耗<0.12 dB@<40 GHz。
(2)并联接触式开关
接触并联式开关同接触串联式不同的是,当悬臂梁被拉下后,接触电极并未将信号通路接通,而是将信号通路与地线相连,将信号旁路到地线,这类开关在小于20 GHz有较好的插入损耗和隔离度,这类开关的研究还比较少[4]。
台湾大学研制出一种旁路型曲梁欧姆接触式开关。开关的驱动电压约为26~30 V,切换时间约为10 ms,插入损耗为0.5 dB@10 GHz,隔离度为17 dB@10 GHz。
2 MEMS开关的发展现状与优缺点
世界上第一个MEMS开关是由美国IBM的K.E.Peterson[5]研制成功的,受当时MEMS加工工艺的限制,该开关的性能并不稳定;直到20世纪90年代,随着MEMS加工技术发展,MEMS开关才取得了跨越式的进步:如1991年Larson[6]制作的旋转式MEMS开关,1996年Goldsmith[7]等人研制出一种低驱动电压电容式MEMS开关,1998年Pachero[8]设计的螺旋型悬臂式MEMS开关结构等,以上各类开关不同性能都在一定程度上有所提升。进入21世纪以来,深入研究RF MEMS开关的公司、研究机构越来越多,国外的有美国Raytheon公司、Motorola公司、麻省理工大学、哥伦比亚大学、加州大学伯克利分校,韩国三星公司、LG公司、首尔大学,日本三菱株式会社、松下公司等,国外的很多商业公司对MEMS开关的研究已进入产品化阶段。国内的MEMS开关研究起步较晚,相关的科研院所有清华大学、东南大学、北京邮电大学、南京电子器件研究所、石家庄54所等。
MEMS开关与传统开关相比具有损耗低、功耗低、线性度好、隔离度高、尺寸小、易集成等优势,避免了传统FET、pin开关由于P-N结和金属半导体结带来的欧姆损耗、I-V非线性,克服了传统外置分立元件带来的体积大、功耗大和元件连线带来的寄生影响,可代替传统半导体器件应用于微波系统中,例如RF MEMS移相器、RF MEMS 智能天线、T/R模块、雷达预警、战术战略侦察、卫星组网和制导等军事领域,还可应用于手机等移动设备、消费级电子产品和导航系统等民用领域。但是MEMS开关还具有以下的缺点:
(1)驱动电压较高:MEMS开关需要驱动机械结构,故驱动电压通常达到了20~80 V甚至更高,而普通开关一般需要3~5 V。降低驱动电压是MEMS开关的研究热点之一,通过优化开关结构、材料可以有效降低开关驱动电压。
(2)可靠性较差:MEMS开关易受到应力、潮湿、高温高压等内外界因素的影响,发生断裂、粘附、介质击穿等失效现象,导致开关可靠性降低,MEMS开关的寿命很低,通常只有1~100亿次。
(3)开关时间长:MEMS开关的开关速度很慢,开关时间在微秒级,是传统开关的1 000倍。
(4)环境要求高:MEMS开关对于工作环境的要求较高,开关的封装质量对开关的性能影响很大,封装的高成本是开关集成商业化应用的瓶颈。
(5)功率处理能力低:处理大功率的射频信号易导致MEMS开关失效,降低开关的可靠性,这大大限制了MEMS开关在大功率射频领域的应用。
3 MEMS开关技术主要问题
根据MEMS开关不同的结构和功能,相应会有不同的工艺技术和问题。一般面临的主要问题有牺牲层技术、封装技术、可靠性问题等。
3.1 牺牲层技术
在制作RF MEMS开关的过程中,需要借助牺牲层来实现微桥等悬空结构的制作。通常的工艺步骤是在传输线或下电极上沉积牺牲层,再在牺牲层上沉积所要制作的悬空结构,最后将牺牲层去除,释放悬臂、微桥等结构。牺牲层采用的材料主要有正性光刻胶、聚酰亚胺、SiO2等,光刻胶和聚酰亚胺做牺牲层的工艺方法类似,都是经过旋涂、固化、图形化等步骤,最后再将牺牲层去除,两种材料都可以采用湿法腐蚀和干法刻蚀的方法来去除,光刻胶易溶于丙酮故容易释放,但在140 ℃以上的高温易变性,变性后的光刻胶用湿法和干法都难以去除,使用对于后续工艺条件产生很大的限制;聚酰亚胺稳定工作的温度高于光刻胶,在230 ℃以下可以用NaOH溶液腐蚀,也可以采用等离子体刻蚀的方法来去除。SiO2容易生长,表面相对平整,一般使用HF缓冲液去除,长时间的浸泡会影响硅片与金属的黏附性。牺牲层材料的选取应当综合考虑后续工艺条件及释放工艺的可行性。
聚酰亚胺综合考虑牺牲层技术与其他工艺的兼容性及释放的难易来选择材料及工艺,在RF MEMS开关微桥的释放工艺中,主要采用可溶性的聚酰亚胺作为牺牲层。去除牺牲层的方法主要有干法刻蚀和湿法腐蚀。
3.2 封装技术
RF MEMS开关因其本身体积小、重量轻等原因在工作时极易受到外界振动、湿度、温度等环境的影响,对MEMS开关进行封装不仅可以有效隔离外部环境的影响,还为实现与外电路及其他部件的沟通搭建了桥梁,为MEMS开关能够良好地放置、固定提供机械支撑[9],高质量的封装技术将会大大提升MEMS开关的性能。对不同的MEMS开关设计不同的封装技术,克服封装条件严苛、成本昂贵等难题,使其能够与开关结构良好兼容、匹配,是MEMS开关器件发展过程中的重要一环。MEMS开关在封装过程中应当要解决以下问题:
(1)封装材料的选取:据MEMS开关封装起到的坚实基底、实现互连、保护开关结构的作用,分别选取相应的材料。封装材料的热膨胀系数、介电常数等应当与开关材料匹配,避免MEMS开关由于与封装材料参数不兼容产生的脱离,或内部应力过大、介电影响等产生的开关性能降低。
(2)降低封装环境的影响:MEMS开关对于工作环境的要求很高,振动、应力、潮湿、腐蚀、温度等都会影响MEMS开关的正常工作。所以在封装的过程中应当采取一定措施来避免上述等因素的介入,例如降低封装载荷、严格控制气密性封装气氛中的湿度、控制封装环境的温度、压力等因素,并进行散热结构的设计以降低热环境产生的开关结构失效,尽可能地降低封装对于MEMS开关性能的影响。
3.3 可靠性问题
要加快MEMS开关的商业化步伐,必须提高MEMS开关的可靠性,使其在应用系统中寿命更长、更加可靠。开关失效主要有开关本身机械结构的蠕变、断裂、疲劳,接触结构的磨损、粘附、介电层的损坏,还有外部环境导致的上述失效。目前对于MEMS开关可靠性的研究还处于初级阶段,应从结构设计、材料选取、工艺设计等各方面入手来解决可靠性的问题。对于接触式MEMS开关失效主要由接触材料失效引起,如材料触点接触电阻变化、接触表面材料的磨损、迁移,一般来说接触材料会选择硬度低的金属例如Au,它接触面积大,接触电阻稳定,但也因硬度不高导致结构稳定性差,通过掺杂其他金属离子可以提升金属作为接触材料的可靠性[10]。另外通过对MEMS开关器件的结构进行优化设计,尽可能弥补选用材料本身对于器件性能的降低。而对于电容式MEMS开关,由于介质层充电时电荷注入和陷阱存在,使得累积电荷影响驱动电压或发生粘附作用,弥补这种缺陷可从介质材料和驱动电压的优化方面入手,可选用陷阱密度低或者能够自身复合陷阱电荷的介质材料[11]来延长开关寿命,选用优化的驱动电压以降低介质层的充电时间[12]或者释放掉陷阱俘获的电荷[13],也能够使得开关的可靠性得到提升。
4 MEMS开关技术的应用
MEMS开关不仅可以单独应用于电路,也可以组成各类组件和应用系统来使用,这不仅可以改善单个开关的性能,而且因与其他组件的结合,可使MEMS开关实现更多的功能,这大大拓宽了MEMS开关的应用范围。
4.1 RF MEMS移相器
根据MEMS开关不同的特性,将多个开关进行串联或并联所形成的开关组往往具有更高的可靠性和性能,例如将电容式开关并联组成开关组可以提高隔离度[14]。将开关级联可以形成各类移相器,通过设计开关数量可以改变相移步进,通过控制开关通断来实现相移[15]。
4.2 RF MEMS 滤波器
随着通信技术的发展,应用于高要求的雷达、接收器、混频器等当中的RF MEMS滤波器受到了极大的关注,通过利用MEMS开关控制信号传输的通断可实现滤波器的模拟和数字可调[16-19]。
4.3 RF MEMS可调电容/电感
MEMS电容/电感具有尺寸小、Q值高等优点,利用 MEMS开关的通断,控制可调电容/电感机械结构的运动,从而实现电容值/电感值的可调[20-21]。
4.4 系统级可重构天线
可重构天线是由天线阵列和MEMS开关组合形成的,通过控制开关网络可使天线实现不同工作频带和不同工作模式的切换[22],故可重构天线可以应用对于频率、模式需求多样化的系统中,例如对应不同通信模式的自动导航系统、覆盖不同通信频率的无线局域网和宽带电视接收机。
4.5 微波收发系统
微波收发系统[23]集合了包括MEMS开关在内的多种RF MEMS元件、组件,形成了由放大器、混频器、锁相环电路等组成的接收电路。MEMS接收机具有高Q值、尺寸小、易集成等优点。
5 结语
RF MEMS开关极大影响了MEMS的进一步发展,为实现MEMS开关产品化、突破MEMS开关发展的局限性,还需解决驱动电压、响应时间、封装质量的问题,对新结构进行优化设计和仿真,改良工艺方案,解决封装和可靠性难题,是提升MEMS开关性能的关键。
来源:《电子技术应用》 刘立,胡磊,丑修建
参考文献
[1] 侯智昊,刘泽文,胡光伟,等.串联电容式RF MEMS开关设计与制造研究[J].传感技术学报,2008(4):660-663.
[2] 梁春广.RF MEMS技术[J].微纳电子技术,2002(l):6-8.
[3] YAO J J,CHANG M F.A surface micromachined miniature switch for telecommunications applications with signal frequencies from DC up to 4 GHz.Tech.Digest,8th Int.Conf.on Solid一State Sensors and Actuators.1995:384-387.
[4] 魏华征.并联接触式射频MEMS开关的研究[D].上海:华东师范大学,2004.
[5] PETERSEN K E.Micromechanical membrane switches on silicon[J].Ibm Journal of Research & Development,1979,23(23):376-385.
[6] LARSON L E,HACKETT R H,MELENDES M A,et al.Micromachined microwave actuator(MIMAC) technology-a new tuning approach for microwave integrated circuits[C].IEEE Microvvave and Millimeter-Wave Monolithic Civcuits Symposium,1991:27-30.
[7] GOLDSMITH C,RANDALL J,ESHELMAN S,et al.Characteristics of micromachined switches at microwave frequencies[C].Microwave Symposium Digest,1996.,IEEE MTT-S International,1996:1141-1144.
[8] PACHECO S,NGUYEN C T,KATEHI L P B.Micromechanical electrostatic K-Band switches[C].Proceedings of IEEE MTT-S International Microwave Symposium.2001:1569-1572.
[9] 胡梅丽,赖宗声,茅惠兵,等.RF/MW MEMS开关中聚酰亚胺的牺牲层技术研究[J].微电子学,2005(1):5-7.
[10] 张永华,曹如平,赖宗声.静电式RF MEMS开关的可靠性[J].微纳电子技术,2010,47(11):701-707.
[11] EHMKE J C,GOLDSMITH C L,YAO Z J,et al.Method and apparatus for switching high frequency signals:,US6700172[P].2004.
[12] WONG W S H,LAI C H.Longer MEMS switch lifetime using novel dual-pulse actuation voltage[J].IEEE Transactions on Device & Materials Reliability,2009,9(4):569-575.
[13] YAMAZAKI H,IKEHASHI T,OHGURO T,et al.An intelligent bipolar actuation method with high stiction immunity for RF MEMS capacitive switches and variable capacitors[J].Sensors & Actuators A Physical,2007,139(1):233-236.
[14] 宣云.RF MEMS开关器件研究[D].北京:清华大学,2005.
[15] TUNG R C,FRUEHLING A,PEROULIS D,et al.Multiple timescales and modeling of dynamic bounce phenomena in RF MEMS switches[J].Microelectromechanical Systems Journal of,2014,23(1):137-146.
[16] BAE H C,MOON J T.FBAR Duplexer Module and Fabrication Method Thereof[P].US,2012.
[17] KIM Y D,LEE I O,CHO I H,et al.Hybrid dual full-bridge DC-DC converter with reduced circulating current,output filter,and conduction loss of rectifier stage for RF power generator application[J].IEEE Transactions on Power Electronics,2014,29(29):1069-1081.
[18] GINER J,URANGA A,TORRES F,et al.Fully CMOS integrated bandpass filter based on mechanical coupling of two RF MEMS resonators[J].Electronics Letters,2010,46(9):640-641.
[19] KARIM J,NORDIN A N,ALAM A H M Z.Design of a pierce oscillator for CMOS SAW resonator[C].International Conference on Computer and Communication Engineering,2012:490-493.
[20] MASTROPAOLO E,WOOD G S,GUAL I,et al.Electrothermally actuated silicon carbide tunable MEMS resonators[J].Journal of Microelectromechanical Systems,2012,21(4):811-821.
[21] SERRANO D,TABRIZIAN R,AYAZI F.Electrostatically tunable piezoelectric-on-silicon micromechanical resonator for real-time clock[J].IEEE Transactions on Ultrasonics Ferroelectrics & Frequency Control,2012,59(3):358-365.
[22] WI S H,KIM J S,KANG N K,et al.Package-level integrated LTCC antenna for RF package application[J].IEEE Transactions on Advanced Packaging,2007,30(1):132-141.
[23] 李胜先.RF MEMS技术现状及主要问题[J].空间电子技术,2012,9(4).

 粤公网安备 44030902003195号
粤公网安备 44030902003195号